-
カテゴリ別
-
場所
-
最新のお知らせ 年間スケジュール(就職対策講座等) OB・OG情報 システムの利用方法 学内合同企業説明会(「九州大学生のための業界・企業研究」) 学内企業研究セミナー / 個別企業説明会 公務員・教員等採用情報 就職相談 就職情報室 キャリア教育 低年次学年向け情報 インターンシップ等(学生向け) TOEIC対策プログラム 博士人材のための就職支援(学生向け) 外国人留学生のための就職支援 未内定の学生及び既卒者(卒業後3年以内)の皆様へ 障害のある学生のための就職支援 部局独自の就職支援 東京・大阪・博多駅オフィスの利用 各種情報サイト 過去の就職状況 採用選考に関する指針 学内合同企業説明会 博士人材のための企業説明会(企業向け) 本学へのご訪問 求人情報ご提供 OB・OG名簿ご提供 インターンシップ等(企業向け) 外国人留学生の採用 採用選考に関する指針 就職担当 よくあるご質問
Research Results 研究成果
「宇宙線ミュオン」が電子機器の誤作動を引き起こす ~超スマート社会の安全・安心を支えるソフトエラー評価技術の開発に向けて~
2018.05.29研究成果Math & DataTechnology
スマートフォンやパソコンだけでなく、冷蔵庫などの家電に至るまでコンピューターが搭載されるようになり、電子機器は私達の生活には欠かせないものとなりました。しかし、最近では、これら電子機器の誤作動を引き起こす原因の一つとしてソフトエラーと呼ばれる現象が注目されています。ソフトエラーとは一過性の誤作動や故障のことで、その要因の一つは宇宙線が電子機器に衝突して生じる半導体デバイスのビット情報反転です。宇宙線は地上に降り注ぐ自然の放射線で、この正体は目に見えない中性子やミュオンです。半導体デバイスの微細化・低消費電力化が進むにつれ、放射線耐性は低下しており、従来懸念されてきた宇宙線中性子ばかりでなく、宇宙線ミュオンによるソフトエラー発生の可能性も指摘されています。
九州大学大学院総合理工学研究院の渡辺幸信教授と大学院総合理工学府博士後期課程1年の真鍋征也、大阪大学大学院情報科学研究科の橋本昌宜教授と同博士後期課程3年の廖望ほか、高エネルギー加速器研究機構 物質構造科学研究所、J-PARCセンター、日本原子力研究開発機構(JAEA) 原子力基礎工学研究センターの11名からなる共同研究チームは、J-PARC物質・生命科学実験施設(MLF)内のミュオン実験装置MUSEにて、半導体デバイスに対する正および負ミュオン照射試験を行い、正ミュオンに比べて負ミュオンの方がメモリ情報のビット反転の発生確率が高くなることを実験的に初めて明らかにしました。
今回の実験で、ソフトエラー発生には半導体デバイス内に停止する低エネルギーミュオンによる影響が大きいこと、特に負ミュオンの方が正ミュオンより高い発生確率を示すことが明らかになりました。これは、負ミュオンの停止した場所での捕獲反応に起因します。
負ミュオンの照射実験結果の報告はこれまでになく、ソフトエラーの正確な評価とそれに対する対策はIoTの進展による超スマート社会の実現に寄与すると考えられます。今後は、さらに試験データを蓄積し、シミュレーション手法の精度を高めたソフトエラー発生率の評価技術を確立し、その技術を次世代半導体デバイスの設計などに応用することで、自動運転やIoT分野の安心・安全な半導体技術の創出に貢献することが期待されます。
本研究は、文部科学省科学研究費補助金(16H03906)の助成を受けて行われました。
また、本研究成果は、2018 年5月24 日(木)(日本時間)に「IEEE Transaction on Nuclear Science誌(電子版)」に掲載されました。
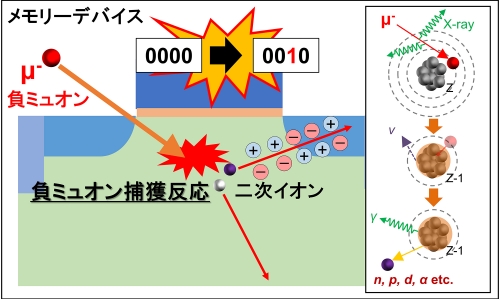
(参考図)
負ミュオンが半導体メモリデバイスに入射し、負ミュオン捕獲反応で発生した二次イオン(陽子やヘリウム等)により電荷が付与されて、ビット情報反転が生じる現象の模式図
研究者からひとこと
宇宙線によるソフトエラー対策の重要性が指摘されています。本研究成果に基づいてエラー発生機構をさらに解明し、発生率の正確な評価とその対策に貢献する技術開発を進めていきます。
- 本研究についての詳細は こちら
論文情報
Negative and Positive Muon-Induced Single Event Upsets in 65-nm UTBB SOI SRAMs ,IEEE Transaction on Nuclear Science,10.1109/TNS.2018.2839704









































